Fájl:Illustration of C-V measurement.gif
Illustration_of_C-V_measurement.gif (322 × 308 képpont, fájlméret: 93 KB, MIME-típus: image/gif, ismétlődik, 18 képkocka, 5,4 s)
Fájltörténet
Kattints egy időpontra, hogy a fájl akkori állapotát láthasd.
| Dátum/idő | Bélyegkép | Felbontás | Feltöltő | Megjegyzés | |
|---|---|---|---|---|---|
| aktuális | 2010. május 17., 21:26 | 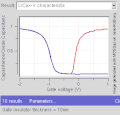 | 322 × 308 (93 KB) | Beatnik8983 | {{Information |Description={{en|1=C-V measurements can reveal oxide thickness, oxide charges, contamination from mobile ions, and interface trap density in wafer processes. In this image the C-V profile for a bulk p-type substrate MOSCAP with different ox |
Fájlhasználat
Az alábbi lap használja ezt a fájlt:
Globális fájlhasználat
A következő wikik használják ezt a fájlt:
- Használata itt: en.wikipedia.org
- Használata itt: fa.wikipedia.org
- Használata itt: ja.wikipedia.org
- Használata itt: ru.wikipedia.org
- Használata itt: zh.wikipedia.org
